在集成电路制造工艺中,光刻是决定集成器件集成度的核心工序,该工序的作用是将图形信息从掩模版(也称掩膜版)上保真传输、转印到半导体材料衬底上。光刻工艺的基本原理是利用涂敷在衬底表面的光刻胶的光化学反应作用,记录掩模版上的器件图形,从而实现将集成器件图形从设计转印到衬底的目的。
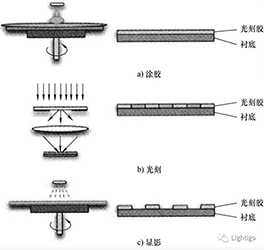
光刻工艺的关键指标包括分辨率、灵敏度、套准精度、缺陷率等。光刻工艺中最关键的材料是作为感光材料的光刻胶。光刻胶按极性可分为正光刻胶(简称正胶)和负光刻胶(简称负胶)两种,其性能差别在于:负光刻胶曝光区域在曝光显影后变硬而留在晶圆片表面,未曝光部分被显影剂溶解;正光刻胶经过曝光后,曝光区域的胶连状聚合物会因为光溶解作用而断裂变软,最后被显影剂溶解,而未曝光的部分则保留在晶圆片表面。先进芯片的制造大都使用正光刻胶,这是因为正光刻胶能达到纳米图形尺寸所要求的高分辨率。16nm/14nm及以下技术代在通孔和金属层又发展出正胶负显影技术,将未经曝光的正光刻胶使用负显影液清洗掉,留下曝光的光刻胶,这种方法可提高小尺寸沟槽的成像对比度。
典型的光刻工艺的主要过程包括5个步骤:底膜准备→涂光刻胶和软烘→对准、曝光和曝光后烘→显影坚膜→显影检测。
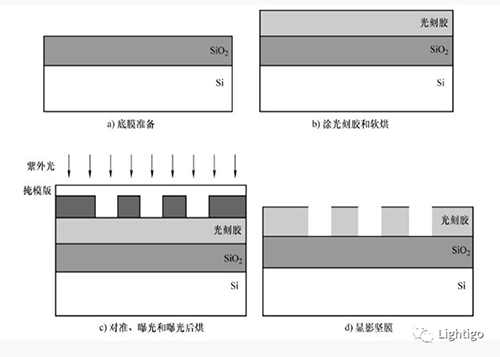
1)底膜准备:主要是清洗和脱水。因为任何污染物都会减弱光刻胶与晶圆片之间的附着力,所以彻底的清洗可以提升晶圆片与光刻胶之间的黏附性。
2)涂光刻胶和软烘:通过旋转硅片的方式实现。对于不同的光刻胶要求不同的涂胶工艺参数,包括旋转速度、胶厚度和温度等。软烘:通过烘烤可以提高光刻胶与硅片的黏附性,以及光刻胶厚度的均匀性,以利于后续刻蚀工艺的几何尺寸的精密控制。
3)对准、曝光和曝光后烘:对准和曝光是光刻工艺中最重要的环节,是指将掩模版图形与晶圆片已有图形(或称前层图形)对准,然后用特定的光照射,光能激活光刻胶中的光敏成分,从而将掩模版的图形转移到光刻胶上。对准和曝光所用的设备为光刻机,它是整个集成电路制造工艺中单台价格最高的工艺设备。光刻机的技术水平代表了整条生产线的先进程度。曝光后烘指的是曝光后进行短时间的烘焙处理,其作用与在深紫外光刻胶和常规i线光刻胶中的作用有所不同。对于深紫外光刻胶,曝光后烘去除了光刻胶中的保护成分,使得光刻胶能溶解于显影液,因此曝光后烘是必须进行的;对于常规i线光刻胶,曝光后烘可提高光刻胶的黏附性并减少驻波(驻波对光刻胶边缘形貌会有不良影响)。
4)显影坚膜:即用显影液溶解曝光后的光刻胶可溶解部分(正光刻胶),将掩模版图形用光刻胶图形准确地显现出来。显影工艺的关键参数包括显影温度和时间、显影液用量和浓度、清洗等,通过调整显影中的相关参数可提高曝光与未曝光部分光刻胶的溶解速率差,从而获得所需的显影效果。坚膜又称为坚膜烘焙,是将显影后的光刻胶中剩余的溶剂、显影液、水及其他不必要的残留成分通过加热蒸发去除,以提高光刻胶与硅衬底的黏附性及光刻胶的抗刻蚀能力。坚膜过程的温度根据光刻胶的不同及坚膜方法的不同而有所不同,以光刻胶图形不发生形变为前提,并应使光刻胶变得足够坚硬。
5)显影检测:即检查显影后光刻胶图形的缺陷。通常利用图像识别技术,自动扫描显影后的芯片图形,与预存的无缺陷标准图形进行比对,若发现有不同之处,就视为存在缺陷。如果缺陷超过一定的数量,则该硅片被判定未通过显影检测,视情况可对该硅片进行报废或返工处理。在集成电路制造过程中,绝大多数工艺都是不可逆的,而光刻是极少数可进行返工的一道工序。
上文我们简述了光刻工艺的大致流程,接下来介绍在光刻工艺中所需用到的必备材料以及设备,例如掩模版、光刻胶、匀胶机、光刻机等等,由于需要保持讲述工艺的完整性以及流畅,每一个都需要涉及,所以每次仅是侧重点不同,这里主要讲述的是掩模版及其工作原理、组成等等。
掩膜版——高精度光刻的关键
掩膜版(Photomask),又称光罩、光掩膜、光刻掩膜版等,是微电子、集成光电子制造中光刻工艺所使用的图形母版, 由不透明的遮光薄膜在透明基板上形成掩膜图形,并通过曝光将图形转印到晶圆上。其工作原理如图三。
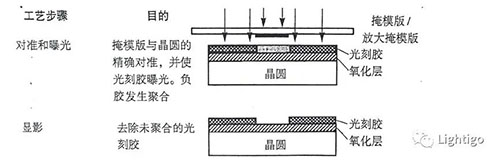
图三 掩模版工作原理
掩模版在设计时有着明场和暗场之分,在其与之光刻胶(正、负胶)曝光时可以根据工艺时的需要来选择设计。上文已经提到正光刻胶曝光区域被溶解,负胶则相反。如图四所示。

图四 掩模版特性
掩膜版主要由基板和遮光膜两个部分组成。基板分为树脂基板和玻璃基板,玻璃基板主要包括石英基板和苏打基板,根据遮光膜种类的不同,可以分为硬质遮光膜和乳胶。

图五 掩模版分类
在如此多种类的掩模版中如何去挑选更为适合所需工艺要求的,就要简单了解它们的优缺点。首先基板衬底必须具备良好的光学透光特性、尺寸及化学稳定性,表面平整、光洁,无夹砂、半透明点及气泡等微小缺陷。具体比较如下表所示:


再者就是对不同遮光膜的介绍,这里其实可以先简单提及光刻技术的发展如图六所示:
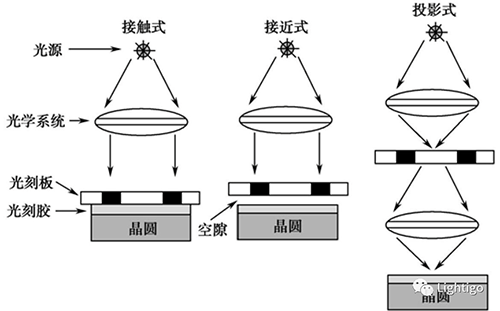
图六 光刻技术发展
可以看到,根据掩膜曝光方式的不同,分为接触式曝光,接近式曝光和投影式曝光。90年代以来,投影式曝光光刻技术成为了光刻技术的主流。在这之后,当技术节点发展到32nm时,传统光刻的光学特点在极小尺寸下受到物理规律的限制必须采用其他的辅助技术继续提升其分辨率。其中这些辅助技术多是针对掩膜版的改进。而当最小线宽小于28nm,则需要多重曝光技术将掩模版拆分成多个,分别进行曝光。
匀胶铬版光掩膜
在接触式光刻技术时代,用超微粒乳胶干版投片,虽然乳胶版具有制作容易、成本低的优点,但是由于其胶膜面软,存在易擦伤和沾污、清洁处理困难、使用寿命短等缺点。匀胶铬版的制作工艺相对复杂、技术难度大、成本高,但它具有分辨率高、缺陷低、耐磨、易清洁处理、使用寿命长的优势,适用于制作高精度、超微细图形,现已逐渐替代接触式乳胶干版掩模,成为集成电路掩模的关键材料。目前还是一部分用的是接触式曝光,选择依旧还是铬版为主。匀胶铬版光掩模可应用的光学范围很广,覆盖了g线、i线,以及包括KrF(波长248nm)和ArF(波长193nm)的深紫外光刻工艺,曝光光源的波长极限决定了关键尺寸的技术节点。
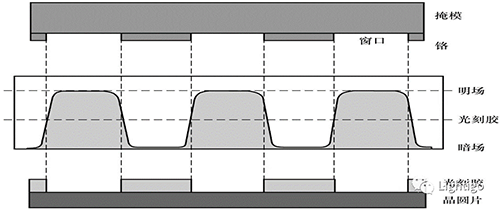
图七 匀胶铬版曝光原理
移相光掩模
当集成电路图形的关键尺寸和间距达到曝光光源的波长极限时,传统的匀胶铬版在光学衍射作用下,相邻部分的光强将相互叠加,造成投影对比度不足而无法正确成像。为了提高曝光分辨率的极限,引入了利用光学相位差增加光强对比度的移相掩模版。此类掩模版需要利用光学相位差进行光强补偿,由于光刻机的曝光波长不同(如曝光波长为248nm的KrF深紫外光刻机,或曝光波长为193nm的ArF光刻机),需要分别使用对应248nm或193nm波长下可提供180 °相位补偿透光光强的KrF移相光掩模或ArF移相光掩模。
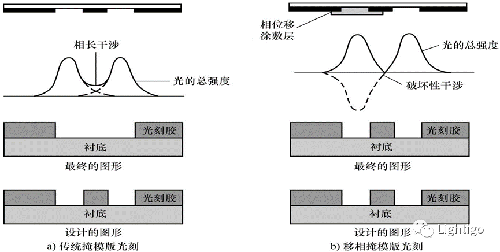
图八 移相掩模版曝光原理
极紫外光掩模
集成电路技术节点的不断发展,出现了以极紫外为曝光光源(光源波长为13~15nm,一般为13.5nm)的极紫外光刻(EUVL)技术。由于其曝光波长极短,这样的曝光环境下物质吸收性很强,传统的穿透式光刻掩模版不能继续使用,而要改成适应反射式光学系统多层堆叠结构的反射型掩模版,包括中间层、顶部覆盖层钌(Ru)和吸收层TaN等。其中,掩模中间层是由金属Mo和Si组成的多层膜结构,对极紫外光有较高的反射系数。由于13nm的极紫外光具有X射线光谱特性,可实现反射微影过程的图形转移和传递几乎无失真,因此掩模的图形设计和相关工艺复杂程度可以得到相应的降低。对于极紫外光掩模的制备,除了图形关键尺寸缩小带来的工艺挑战以外,在应用过程中的高热稳定性和抗辐射技术也需要重视。由于发射型掩模版进行传统的蒙版保护,所以掩模的储存、运输及操作等非常困难。在此基础上,极紫外光掩模在微影曝光端的应用,必须与光掩模检验、清洗和修补机台组合在一起,以避免使用过程中的污染或其他原因在芯片上造成的缺陷,而这将导致微影端工艺和设备的维护费用非常高,反过来又促使掩模制造方抓紧对高温耐久的掩模蒙版的研发。
文章来源:Lightigo
联系人:袁经理
手机:051683539599
电话:051683539599
邮箱:ziyu.yuan@ae-fab.com
地址: 徐高新康宁路1号高科金汇大厦A座14楼