上两篇对于光刻工艺中所用到的掩膜版和光刻胶进行了简单的介绍。其实在光刻工艺的整个流程中有几样设备也是不能缺少的。例如:光刻机、匀胶机、烘胶机(烤胶机)以及显影设备等等。这次主要来介绍光刻机以及其中相对应的曝光源。
随着光刻技术的发展经历了接触/接近式光刻、光学投影光刻、步进重复光刻、步进扫描光刻、浸没式光刻、EUV光刻以及电子束光刻。主流的曝光源的曝光波长由g线(436nm)、i线(365nm)、KrF(248nm)、ArF(193nm),一直缩减到极紫外线(EUV)(13.5nm)。
一、接触/接近式光刻机
接触式光刻技术是小规模集成电路时代的主要光刻手段,主要用于生产特征尺寸大于5μm的集成电路。在接触/接近式光刻机中,通常晶圆片放置于手动控制水平位置和旋转的工件台上。利用分立视场显微镜同时观察掩模和晶圆片的位置,并通过手动控制工件台的位置来实现掩模版与晶圆片的对准。晶圆片与掩模版对准后,二者将被压紧,使得掩模版与晶圆片表面的光刻胶直接接触。移开显微镜物镜后,将压紧的晶圆片与掩模版移入曝光台进行曝光。汞灯发出的光经透镜准直平行照射掩模版,由于掩模版与晶圆片上的光刻胶层直接接触,所以曝光后掩模图形按照1:1的比例移转印至光刻胶层。
接触光刻技术优点:因直接接触,减少光的衍射,能实现较小特征尺寸的曝光。总体简单经济。缺点:也是因掩膜版和涂油光刻胶的晶圆紧密接触,容易造成划痕、污染颗粒,同时造成器件致命的缺陷,缩短掩膜版的寿命,降低成品率等。
在大规模的集成电路生产中,为避免因掩模版与晶圆片的直接接触而导致的与接触式光刻不同,接近式光刻中的掩模版与晶圆片上的光刻胶之间充了氮气,掩模版浮在氮气之上,掩模版与晶圆片之间的间隙大小由氮气的气压来决定。由于接近式光刻技术不存在晶圆片与掩模版的直接接触,减少了光刻过程中引入的缺陷,从而降低了掩模版的损耗,提高了晶圆片成品率。接近式光刻技术中,晶圆片与掩模版存在的间隙使得晶圆片处于菲涅耳衍射区域。而衍射的存在限制了接近式光刻设备分辨率的进一步提高,因此该技术主要适用于特征尺寸在3μm以上的集成电路生产。
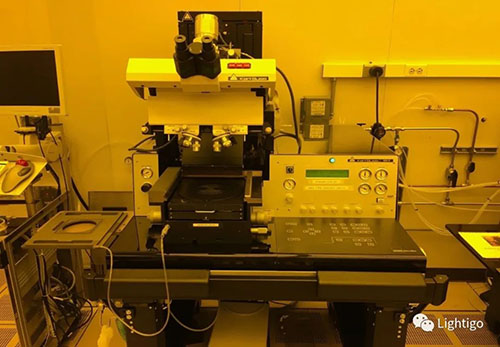
接触式光刻机
二、步进重复/扫描光刻机(步进式也称之为投影式)
接触/接近式光刻机实现了亚微米工艺的实现,那么步进重复光刻机的出现推动亚微米工艺的发展以及进入了量产。步进重复光刻机利用22mm × 22mm的典型静态曝光视场和缩小比为5:1或4:1的光学投影物镜,将掩模版上的图形转印到晶圆片上。
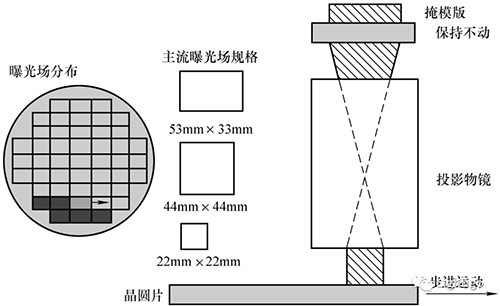
步进重复光刻的工作原理图
步进重复光刻机一般由曝光分系统、工件台分系统、掩模台分系统、调焦/调平分系统、对准分系统、主框架分系统、晶圆片传输分系统、掩模传输分系统、电子分系统和软件分系统组成。工作流程这里就先不仔细介绍,总的来说就是对准,而后从一点到另一点逐场曝光。
后续发展起来的步进扫描光刻机是在上述基本工作过程的基础上,将步进→曝光改进为扫描→曝光,调焦/调平→对准→曝光在双台机型上改进为测量(调焦/调平→对准)与扫描曝光并行。步进重复光刻机与步进扫描光刻机相比,由于步进重复光刻机不需要实现掩模和晶圆片同步反向扫描,在结构上不需要扫描掩模台和同步扫描控制系统,因而结构相对简单、成本相对较低、工作可靠。但当IC工艺进入0.25μm后,由于步进扫描光刻机在扫描曝光视场尺寸及曝光均匀性上均具有优势,使得步进重复光刻机的应用开始慢慢减少。
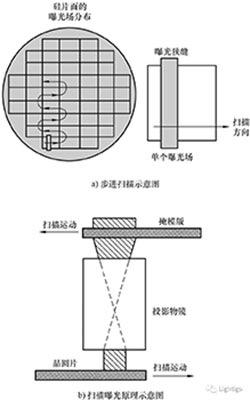
步进扫描光刻的工作原理图
小结:步进重复光刻和步进扫描光刻的工艺节点是0.25um;步进扫描光刻机可以通过配置不同的曝光光源,所以步进扫描技术可支撑不同的工艺技术节点,从365nm、248nm、193nm浸没式,直至EUV光刻;步进扫描光刻机成像系统的静态视场更小。在同等成像性能约束下,投影物镜制造难度降低。因此在0.18μm工艺节点后,即采用KrF光源后,基本采用步进扫描技术,并一直延续到现在。目前在7nm以下工艺节点使用的极紫外(EUV)光刻机也采用步进扫描方式。经过一些必要部分的改造,步进扫描光刻机也可以支撑MEMS、功率器件、射频器件等诸多非硅基底工艺的研发与生产。

ASML的步进扫描光刻机
三、浸没式光刻机
浸没式光刻机是采用折射和反射相结合的光路设计且曝光区域与光刻机透镜之间充满水的光刻设备。对于45nm以下及更高的成像分辨率,采用ArF干法曝光方式已经无法满足要求(因其最大支持65nm成像分辨率),故而需要引入浸没式光刻方法。虽然浸没式光刻机是步进扫描光刻机的一种,但其设备系统方案并无变化,由于引入与浸没相关的关键技术,所以 属于ArF步进扫描光刻机的升级改良版。浸没式光刻的优点:由于系统数值孔径的增大,提升了步进扫描光刻机的成像分辨能力,可以满足45nm以下成像分辨率的工艺要求。缺点:由于浸没液体的引入,导致设备本身工程难度大幅度增加,其关键技术包括浸没液体供给与回收技术、浸没式液场维持技术、浸没式光刻污染与缺陷控制技术、超大数值孔径浸液式投影物镜开发与维护、浸液条件下成像质量检测技术等。这里不作详细的介绍。
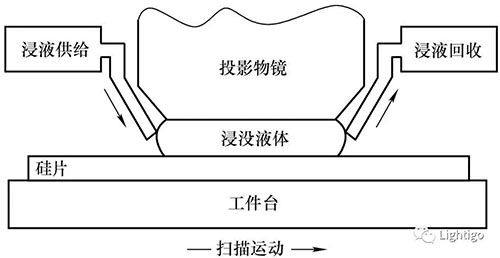
浸没式光刻原理图
四、极紫外光刻机(EUV光刻机)
小于5纳米的芯片晶圆,只能用EUV光刻机生产。为了提高光刻分辨率,在采用准分子光源后进一步缩短曝光波长,引入波长为10~14nm的极紫外光作为曝光光源。目前波长为13.5nm。EUV光刻机主要由光源、照明、物镜、工件台、掩模台、晶圆片对准、调焦/调平、掩模传输、晶圆片传输、真空框架等分系统组成。极紫外光经过多层镀膜的反射镜组成的照明系统后,照射在反射掩模上,被掩模反射的光进入由一系列反射镜构成的光学全反射成像系统,并最终在真空环境下将掩模的反射像投影在晶圆片表面。

EUV光刻原理图
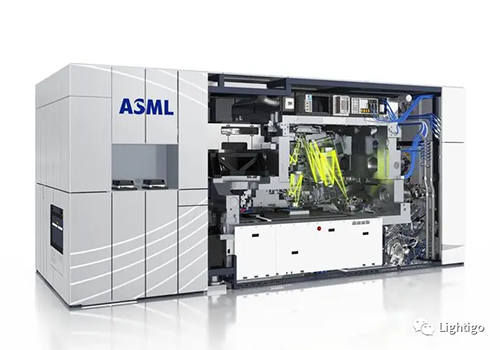
EUV光刻机
五、电子束光刻系统/纳米电子束直写系统
电子束光刻的主要原理:利用高速的电子打在光刻胶表面,使光刻胶的化学性质改变。在电子束光刻中电子的产生方式有两种,一种是热发射,另一种是场发射。热发射是通过对阴极材料高温加热,使电子获得足够的能量从阴极中逸出;场发射是将阴极置于高强度电场中,利用电场对电子的强作用力使电子脱离原子核的束缚。直写式电子束的曝光原理是将聚焦的电子束斑直接打在光刻胶的表面,加工中不需要成本高昂的掩模版和昂贵的投影光学系统,其加工方式也更为灵活,适合小批量器件的光刻,在实际中应用更为广泛。电子束光刻按照曝光方式划分可分为两种,投影式曝光与直写式曝光。
这里再提一嘴,光源的波长是影响光刻精度的主要原因,由于光源波长的限制,X射线曝光可达到50nm左右的精度,深紫外光源的曝光精度在100nm左右,而电子的波长较小,因而电子束光刻的加工精度可以达到10nm以内。电子束光刻以其分辨率高、性能稳定,成本相对较低的特点,因而成为人们最为关注的下一代光刻技术之一对于其光刻胶选择也是有所不一样,。目前常用的电子束光刻胶有PMMA,ZEP520A及HSQ等。

电子束常用胶对比图

电子束光刻机图
文章来源: 尕辉 Lightigo
联系人:袁经理
手机:051683539599
电话:051683539599
邮箱:ziyu.yuan@ae-fab.com
地址: 徐高新康宁路1号高科金汇大厦A座14楼