上一篇简单介绍了湿法刻蚀和干法刻蚀以及它们的优缺点。这一篇对它们进行具体的分析。
首先讲解湿法刻蚀基本原理以及在刻蚀过程中需要注意的关键点。例如:刻蚀所需用到的各种溶液以及之间配比;在刻蚀中主要的影响因素和其解决方法等等。
在湿法刻蚀基本原理是待刻蚀的材料以浸没的形式在特定的溶液中进行腐蚀,使材料和溶液进行一系列的化学反应,从而达到一个腐蚀(刻蚀)的效果。同时要清楚并了解主要的半导体材料;一些常见的酸、碱和溶剂;半导体制程中会用到的金属;在湿法刻蚀中所用到的设备等等。湿法我认为就两个大致目的:一、清洗。二、腐蚀(刻蚀)。常见湿法用处:基材(晶圆)预处理、掩膜准备、刻蚀过程及其控制、刻蚀后处理。
一、半导体材料(主要)以及常用的金属
第一代:锗(Ge)、硅(Si)为主
第二代:砷化镓(GaAs)、 磷化铟(InP)、 锑化铟(InSb) 和硫化镉(CdS) 等I-V族化合物材料为主
第三代:碳化硅(SiC)、 氮化镓 (GaN)、 氧化锌(ZnO)和氮化铝(AIN) 等为代表
常用的金属:铝(Al)、铜(Cu)、铬(Cr)、钛(Ti)、铂(Pt)、金(Au)、银(Ag)等
二、常用的湿法酸、碱、溶剂以及设备
1、酸 :氢氟酸(HF)、盐酸(HCL)、硫酸(H2SO4)、磷酸(H3PO4)、硝酸(HNO3)、醋酸(CH3COOH)、缓冲氧化刻蚀BOE(49%HF水溶液:40%NH4F水溶液=1:6(体积比)的成分混合而成)
2、碱:氢氧化钾(KOH)、氢氧化钠(NAOH)、氢氧化铵(NH4OH)、氢氧化四甲基铵(TMAH)等
3、溶剂:超纯水、丙酮(acetone)、异丙醇(IPA)、二甲苯(Xylenes)、三氯乙烯(TCE)等
4、配合使用的设备:磁力搅拌加热器、超声机、摇床等
三、常见的湿法腐蚀/处理
1、基材(晶圆)预处理
预处理一般是清洗。3个类型:1、颗粒2、有机/无机残留物3、需要去除的保护层(氧化层/牺牲层)

当然关于清洗还有非常多的方式和方法,例如RCA清洗,或者利用臭氧等等,这里就先不作详细介绍。
2、常见基材、钝化层以及金属的腐蚀
大多数在进行湿法腐蚀工艺的时候为了能得到所需的结构,一般是先通过光刻工艺得到第一步的图形,利用光刻胶作为掩膜去腐蚀下一层材料,例如:Si、Sio2、SiN、Al等等。

当然还有光刻胶作为掩膜来腐蚀下面一层的金属薄膜,那么下图主要是常见金属的腐蚀方式方法

3、刻蚀控制
在湿法刻蚀过程中所需要控制的是刻蚀速率从而把握时间控制刻蚀的一个深度。为了保证刻蚀的均匀性,一致性以及准确性要注意几个因素。温度、刻蚀溶液的配比比例以及浓度等等。通过这调节控制这些参数,从而实现刻蚀速率以及刻蚀深度的一个把控。
4、刻蚀后的处理
在湿法刻蚀后一般需要用大量的超纯水进行冲洗,或者通过其他方式对晶圆进行清洗,以便于下一步的工艺加工。如果用到了配套使用的设备需要及时进行清洗维护等等。
5、安全防护
湿法刻蚀毕竟是涉及到多种化学品,在工艺时必须做好防护措施。
小结:对于湿法刻蚀我个人认为首先需要确定好被刻蚀的材料,根据其性质选择相对的刻蚀溶液。再选择保护的掩膜,同时在其他部分材料不被腐蚀的情况下再进行腐蚀。例如晶圆是磷化铟衬底,同时晶圆表面有着一层牺牲层也是磷化铟,在这时去除牺牲层的时候需要在晶圆背后贴上保护膜(蓝膜)。
接下来讲解干法刻蚀。
干法刻蚀(dry etching) :是指以气体为主要媒体,气体在一定条件下以等离子的状态下进行薄膜的刻蚀技术。过程是以物理轰击反应或者化学反应进行刻蚀。
三种干法刻蚀技术:等离子体、离子铣、反应离子刻蚀(RIE)。
干法刻蚀设备:磁场增强反应离子刻蚀设备、电容耦合等离子体刻蚀设备、电感耦合等离子刻蚀设备等等。
干法刻蚀中常见以及常用的气体如下:

气体分类小结:氯基气体、氟基气体、惰性气体(辅助性气体)等。
影响干法刻蚀的主要因素:
气体的成分(组合)、气体纯度以及所用气体之间的流量比、刻蚀过程中设备所提供的频率以及设定的功率大小、刻蚀过程时的腔压大小、样品的温度等等一系列因素。都会影响刻蚀的速率,选择性、均匀性以及刻蚀所得的轮廓。
等离子体刻蚀可以根据等离子体产生和控制技术的不同而大致分为两大类,即电容耦合等离子体(Capacitively Coupled Plasma,CCP)刻蚀和电感耦合等离子体(Inductively Coupled Plasma,ICP)刻蚀。还有反应离子刻蚀(RIE)和磁场增强反应离子刻蚀设备。
1. 电容耦合等离子体刻蚀设备(CCP)
是一种施加在极板上的射频(或直流)电源通过电容耦合的方式在反应腔内产生等离子体并用于刻蚀的设备。一般CCP会用到两到三个不同频率的射频源,目前我所能接触的所用的频率一般是13MHz。当然也有其他频率例如2MHz和4MHz这两个一般是低频射频源,一般接晶圆所在的下电极,因为能有效地控制离子能量,所以也叫偏压电源。相反在27MHz以上的射频源上下电极都可以接,对离子浓度能有效控制,所以叫源电源。
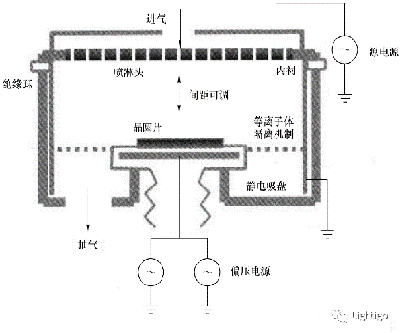
目前来看对于高深宽比结构的刻蚀要求,在工作时候的气压(反应腔)由50~500mTorr低至10mTorr。目的是增加离子的自由程,减少因为碰撞所带来的能量损失。其次为了加强离子能够垂直进入极高深宽比结构底部而不发生偏移,一般采用10kw的偏压电源从而获得更高的离子能量。物极必反,离子能量的大小以及分布对刻蚀的细小部分以及对器件的损伤也是有很明显的影响。CCP目前也是主要用于电介质材料的刻蚀工艺。
2. 电感耦合等离子体设备(ICP)
电感耦合等离子体(ICP)刻蚀设备是一种将射频电源(13.56MHz)的能量经由电感线圈,以磁场耦合的形式进入反应腔内部,从而产生等离子体并用于刻蚀的设备。ICP刻蚀的核心是等离子体,它是由高频电场作用下的气体离子化形成的。在ICP刻蚀系统中,气体通过进气口进入反应室,在高频电场的作用下,气体分子被电离成为正离子和电子。正离子在电场的作用下被加速,撞击到反应室内的壁面,产生二次电子,形成等离子体。等离子体具有高能量、高反应性和高密度等特点,可以在短时间内刻蚀材料表面。ICP刻蚀的刻蚀速率和选择性取决于等离子体的密度和能量。等离子体密度越高,刻蚀速率越快,但选择性越差:等离子体能量越高,刻蚀速率越快,但表面粗糙度越大。因此,ICP刻蚀需要控制等离子体的密度和能量,来达到高精度、高选择性的刻蚀效果。等离子体浓度基本上由连接电感线圈的源电源的功率决定,而晶圆片表面离子鞘中的离子能量则基本上由偏压电源的功率决定,所以离子的浓度和能量能够独立控制,从而实现去耦合。
ICP刻蚀设备是目前各类等离子体刻蚀设备中应用最广泛的两类设备之一,它主要用于对硅沟槽、多晶硅栅结构、金属栅结构。另外,随着三维集成电路、CMOS图像传感器和微机电系统(Micro-electro-mechanical System,MEMS)的兴起,以及硅通孔(Through Si Via,TSV)、大尺寸斜孔槽和不同形貌的深硅刻蚀应用的快速增加,多个生产商推出了专为这些应用而开发的刻蚀设备,其特点是刻蚀深度大(数十甚至数百微米),所以多应用在高气流量、高气压和高功率条件下。
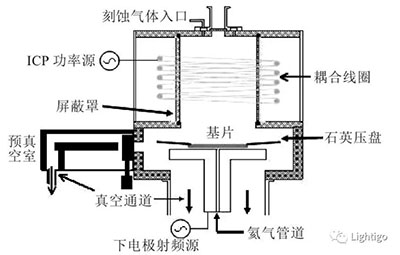
ICP刻蚀设备所面临的挑战和改善方向主要有如下3个方面:
1)刻蚀后关键尺寸(Critical Dimension,CD)均匀性
2)刻蚀选择性
3)等离子体引起的损伤
反应离子刻蚀(RIE)是一种采用化学反应和物理离子轰击去除硅片表面材料的技术,是当前常用技术路径属于物理和化学混合刻蚀。在传统的反应离子刻蚀机中,进入反应室的气体会被分解电离为等离子体,等离子体由反应正离子、自由基、反应原子等组成。反应正离子会轰击硅片表面形成物理刻蚀,同时被轰击的硅片表面化学活性被提高,之后硅片会与自由基和反应原子形成化学刻蚀。这个过程中由于离子轰击带有一定方向性,RIE技术具有较好的各向异性。磁场增强反应离子刻蚀(Magnetically Enhanced Reactive Ion Etching,MERIE)设备是一种在平板式RIE设备的基础上外加一个直流磁场而构成的旨在提高刻蚀速率的刻蚀设备。
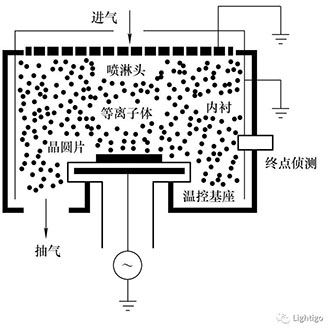
经典RIE简化示意图
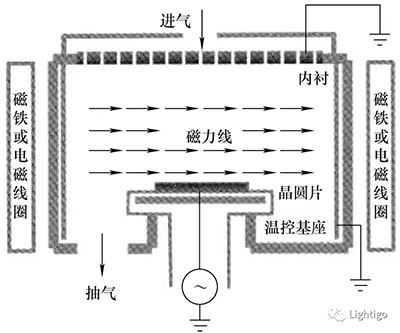
经典MERIE简化示意图
文章来源: 尕辉 Lightigo
联系人:袁经理
手机:051683539599
电话:051683539599
邮箱:ziyu.yuan@ae-fab.com
地址: 徐高新康宁路1号高科金汇大厦A座14楼